
|
|
Электропроводимость примесных полупроводников12
Монокристаллы полупроводников всегда имеют различные неоднородности, дефекты, в том числе и примесные атомы, которые создают собственные энергетические уровни (примесные уровни). Эти уровни могут располагаться как в разрешенной, так и в запрещенной зонах. Для придания полупроводникам необходимых свойств в них специально вводят примеси в нужных пропорциях. Cуществуют два основных типа примесных полупроводников: донорные и акцепторные.
Донорные полупроводники
Четырехвалентный германий имеет решетку типа алмаза, в которой каждый атом окружен четырьмя соседними атомами, связанными с ним валентными силами. Если внедрить в решетку германия атомы пятивалентного мышьяка, то пятый электрон его атомов связи не образует (рис. 3, а).
Этот электрон будет двигаться в поле атома мышьяка, ослабленного в поле решетки германия в e = 16 раз (e - диэлектрическая проницаемость германия), а энергия связи мышьяка уменьшается в ~ 256 раз и cоставляет DW ~ 0,01 эВ, что соответствует энергии активации. При сообщении этому электрону такой энергии он отрывается от своего атома и приобретает способность свободно перемещаться в решетке германия, может переходить в зону проводимости. Образующиеся при этом дырки локализуются на неподвижных атомах мышьяка и в электропроводности не участвуют. Примеси, за счет которых возникает электронная проводимость, называются донорами, а энергетические уровни, на которых расположены электроны примеси, - донорными уровнями DWд (рис. 3, б). Эти уровни располагаются в запрещенной зоне у дна зоны проводимости, имея энергию активации DWд » 0,01 эВ. Уровень Ферми в донорных полупроводниках располагается посередине между донорным уровнем и дном зоны проводимости. Все полупроводники с донорной примесью, называются полупроводниками n - типа. 2.2. Акцепторные полупроводники Если в решетке четырехвалентного германия часть его атомов замещена атомами трехвалентного индия (рис. 4, а), то для образования связей с четырьмя ближайшими соседями у атома индия не хватает одного электрона.
Рис. 4
Им может быть электрон соседнего атома германия, так как для этого требуется энергия (энергия активации) DW~0,01 эВ. На месте ушедшего электрона в разорванной связи атома германия появляется дырка, поэтому в валентной зоне появляется вакансия. Незаполненные энергетические уровни атомов индия располагаются в запрещенной зоне вблизи потолка валентной зоны на расстоянии, соответствующем энергии активации. Уровень Ферми в акцепторных полупроводниках располагается посередине между акцепторным уровнем и потолком валентной зоны. Близость примесных уровней к валентной зоне приводит к тому, что при относительно невысоких температурах электроны из валентной зоны могут переходить на примесные уровни (рис. 4, б). Эти электроны образуют устойчивую связь с атомами индия, теряют способность перемещаться в решетке германия и в проводимости не участвуют. Носителями заряда являются дырки, возникающие в валентной зоне. Примеси, за счет которых возникает дырочная проводимость, называют акцепторами, аэнергетические уровни - акцепторными уровнями DWа (рис. 4, б). Такие полупроводники с акцепторной примесью называют полупроводниками р-типа. Преимущество в применении примесных полупроводников очевидно, если сравнить энергии активации собственного полупроводника германия (DW~0,66 эВ) с донорной или акцепторной примесью (DW ~ 0,01 эВ). Cледовательно, для возбуждения тока в примесных полупроводниках требуется меньшая энергия, чем в собственных полупроводниках.
Рис. 5
Рассмотрим, как осуществляется электропроводность примесных полупроводников.При достаточно низких температурах средняя энергия тепловых колебаний решетки kT значительно меньше ширины запрещенной зоны собственного полупроводника, поэтому эти колебания не могут обеспечить возбуждение электронов валентной зоны и перебросить их в зону проводимости. Но этой энергии достаточно для возбуждения и перехода в зону проводимости электронов с донорных уровней Wд в полупроводниках n - типа (рис. 5, а) и дырок с акцепторных уровней Wа в полупроводниках р - типа (рис. 5, б). По мере повышения температуры в полупроводниках n - типа концентрация электронов в зоне проводимости увеличивается, а их концентрация на донорных уровнях уменьшается (донорные уровни истощаются). Аналогично ведут себя и акцепторные уровни в полупроводниках р - типа. При полном истощении примесей концентрация электронов в зоне проводимости в полупроводниках n-типа становится равной концентрации донорной примеси, а концентрация дырок в полупроводниках р - типа становится равной концентрации акцепторной примеси. Температура истощения примесей ТS тем выше, чем больше энергия активации примеси Wд и Wа и ее концентрация. Например, для германия с концентрацией n ~ 1022 м-3 и DWд= ~ 0,01 эВ температура истощения примеси ТS = 30 К. При дальнейшем повышении температуры начинается все боле интенсивное возбуждение собственных носителей и переход к собственной проводимости полупроводника. Температура Тi такого перехода тем выше, чем больше энергия активации DW и концентрация примеси в нем. Например, для германия Тi = 450 К. На рис. 9.21 приведен график зависимости натурального логарифма концентрации электронов в зоне проводимости полупроводника n - типа от обратной температуры. На графике можно выделить три участка: 1 - отвечающий примесной проводимости полупроводника; 2 - соответствующий области истощения примеси; 3 - отвечающий собственной проводимости полупроводника. В отличие от собственных полупроводников, в которых проводимость осуществляется одновременным движением электронов и дырок, в примесных полупроводниках электропроводность вызвана носителями одного знака: электронами в полупроводниках n - типа и дырками в полупроводниках р - типа, которые называют основными носителями. Помимо основных носителей полупроводники всегда содержат и неосновные носители: донорный полупроводник - дырки, акцепторный - электроны, концентрация которых много меньше, чем концентрация основных носителей в ~106 раз. При температуре выше Т = 0 К в полупроводниках происходит процесс возбуждения (генерация) свободных носителей заряда. Однако вместе с процессом генерации возникает процесс рекомбинации свободных носителей. Процесс рекомбинации состоит в том, что свободный электрон при встрече с вакансией (дыркой) занимает его, в результате чего происходит исчезновение пары электрон - дырка. При любой температуре между процессом генерации и рекомбинации устанавливается равновесие, которому соответствует равновесная концентрация носителей. Помимо теплового возбуждения возможны и другие способы генерации свободных носителей в полупроводниках, например, под действием света, ионизируюшего облучения или введения (инжекции) частиц через контакт двух полупроводников.
В результате этого появляются дополнительные, избыточные носители, которые называют неравновесными. Время жизни таких носителей ограничено до тех пор, пока не произойдет их рекомбинация. Процесс перехода электрона из зоны проводимости в валентную зону, при рекомбинации, может протекать непосредственно через всю запрещенную зону (межзонная рекомбинация) или сначала на примесной уровень, а затем с него в валентную зону (рекомбинация через примесной уровень). При осуществлении обоих типов рекомбинации выделяется одна и та же энергия DW. Различие состоит лишь в том, что в первом случае энергия выделяется сразу, во втором - по частям. Выделение энергии может происходить в виде квантов света (e = hn) или в виде тепла (фононов). В первом случае рекомбинацию называют излучательной, во втором - безызлучательной. Температурная зависимость электропроводности невырожденных примесных полупроводников, как и собственных, определяется температурной зависимостью концентрации носителей. Поэтому качественный характер кривой зависимости g(Т) должен быть аналогичен кривой зависимости n(T), приведенной на рис. 6, где показан график зависимости tgb ~ Участок б-в простирается от температуры истощения примесей ТS до температуры перехода Тi к собственной проводимости. На этом участке все примесные атомы ионизированы, но еще не происходит заметного возбуждения носителей собственного полупроводника. Концентрация носителей остается постоянной, а температурная зависимость электропроводности полупроводника определяется температурной зависимостью подвижности носителей. Если основным механизмом рассеяния носителей в рассматриваемой области является рассеяние на тепловых колебаниях решетки, для которого характерно уменьшение подвижности с ростом температуры, то электропроводимость будет падать, что и наблюдается на графике (рис. 7). Если же основным механизмом является рассеяние на ионизированных атомов примеси, то электропроводность на участке б-в будет увеличиваться с повышением температуры.
Участок в-г соответствует переходу к собственной проводимости полупроводника. Концентрация носителей примеси равна концентрации носителей собственных полупроводников и tga ~ Удельная электропроводность примесного полупроводника находится по формуле
где первое слагаемое отвечает электропроводности за счет носителей примеси; второе слагаемое - за счет носителей собственного полупроводника.
Понятие о n - p переходе
Для выпрямления переменного тока можно использовать контакт двух примесных полупроводников с различным типом проводимости, например, n-р переход. Для получения n-р перехода используют метод плавления, эпитаксиальный метод, метод ионного легирования. В образец чистого полупроводника, например, германия, вводят две примеси - донорную (мышьяк) и акцепторную (индий).
В результате в одной половине образца (слева) возникает полупроводник n - типа (электронная проводимость), а в другой (справа) - полупроводник р - типа (дырочная проводимость). Между ними возникает переходный слой, т. е. n-р контакт. Если оба полупроводника изготовлены на основе одного и того же материала, то границы энергетических зон (валентной и проводимости) в обоих полупроводниках совпадают (рис. 8). Примесные уровни в полупроводнике n - типа расположены в запрещенной зоне вблизи дна зоны проводимости. В полупроводнике р - типа акцепторные уровни находятся также в запрещенной зоне, но вблизи потолка валентной зоны. Поэтому уровень Ферми в полупроводнике n - типа расположен выше, чем в полупроводнике р - типа. Соответственно работа выхода в первом меньше, чем во втором. Для простоты будем считать, что концентрации акцепторов и доноров равны.
Концентрация носителей в собственном полупроводнике составляет 1019м-3; концентрация неосновных носителей составляет »1016 м-3. Из-за большого различия в концентрации основных и неосновных носителей при Т > 0 К возникают диффузионные потоки: электронов из полупроводника n - типа в полупроводник р - типа и дырок из полупроводника р - типа в полупроводник n -типа. При этом область полупроводника n - типа вблизи контакта, заряжается положительно (рис. 9. слева), а область полупроводника р -типа вблизи контакта (рис. 9.24, справа) заряжается отрицательно. Поэтому происходит понижение уровня Ферми в полупроводнике n -типа и повышение его в полупроводнике р - типа. Процесс перехода электронов из полупроводника n -типа и дырок из полупроводника р - типа будет происходить до тех пор пока уровни Ферми не сравняются, и затем устанавливается динамическое равновесие.
Поток электронов из n (слева) в р (справа) уравновешивается потоком электронов из р (справа) в n (слева). Аналогичный процесс происходит и с дырками. Таким образом, уход электронов из приконтактного слоя полупроводника n -типа приводит к возникновению в этом слое объемного положительного заряда ионизированных атомов донорной примеси. Соответственно уход дырок из при контактного слоя полупроводника р - типа вызывает появление в этом слое объемного отрицательного заряда, локализованного на атомах акцепторной примеси. Между этими слоями возникает контактная разность потенциалов, создающая в n-p переходе потенциальный барьер j рn = WF n - WF p (рис. 10), препятствующий переходу электронов из полупроводника n -типа в полупроводник р - типа и дырок из полупроводника р - типа в полупроводник n - типа. Как показывает расчет,
где nno - концентрация электронов основных носителей в полупроводнике n - типа; рро - концентрация дырок основных носителей в полупроводнике р - типа; nро - концентрация дырок неосновных носителей в полупроводнике n - типа; рnо - концентрация электронов неосновных носителей р - типа.
В n-p переходе на основе германия при Т = 300 К jр n » 0,45 эВ. Ширина контактного слоя определяется высотой потенциального барьера и концентрацией основных носителей и составляет d »10 -8 - 10 -6 м. Таким образом, в состоянии равновесия ток через n-p переход отсутствует. Приложим к n-p переходу внешнюю разность потенциалов U, подключив к р-области положительный полюс источника напряжения, а к n-области - отрицательный (рис. 11). Внешняя разность потенциалов вызовет понижение потенциального барьера для основных носителей до jрn - qеU, где qe - заряд электрона.
Ширина контактного слоя уменьшится. Под действием электрического поля поток электронов из n - в р-область и поток дырок из р - в n - область увеличится, что приведет к возникновению прямого тока за счет движения основных носителей. В то же время ток не основных носителей останется неизменным, так как концентрация их не зависит от потенциального барьера n-p перехода. Если приложить к n-p переходу внешнюю разность потенциалов U в обратном направлении, подключив к р-области отрицательный полюс источника напряжения, а к n-области - положительный (рис. 12), то под действием этой разности потенциалов потенциальный барьер n-p перехода повысится до jрn+ qеU, что вызовет уменьшение потока основных носителей (электронов и дырок) и соответственно уменьшение тока через контактный слой n-p перехода в прямом направлении. В итоге возникнет обратный ток, вызванный не основными носителями. Плотность тока через n-p переход находят по формуле
где jS - плотность тока насыщения; знак “+” соответствует прямому току, знак “-“ - обратному току. При внешней разности потенциалов в
обратном направлении и с увеличением ее величина Величина тока насыщения определяется потоком не основных носителей через n-p переход. Например, для германиевых n-p переходов jS »10-2 A/м2. При Т = 300 К отношение прямого тока к обратному составляет » 109, т. е. n-p переход обладает односторонней проводимостью, что характеризует хорошие выпрямляющие свойства n-p перехода. На рис. 13 приведен график вольтамперной характеристики n-p перехода. Кроме диодов существует много типов транзисторов, например, биполярный транзистор, представляющий собой кристалл с двумя р – n переходами, расстояние между которыми много меньше диффузионной длины неравновесных носителей, используется как усилитель электрического сигнала, применяется в интегральных микросхемах.
4. Электрический ток в вакууме
При любой температуре электроны в металлах совершают тепловые хаотические движения. Некоторые из них могут покинуть металл. Чтобы покинуть металл, электрон должен совершить некоторую работу, называемую работой выхода. Согласно зонной теории проводимости твердых тел работа выхода отсчитывается от уровня Ферми до поверхности металла с вакуумом. После того как электрон выйдет из металла в вакуум, он индуцирует на поверхности его заряды противоположного знака. Поэтому между электроном и поверхностью возникает кулоновская сила притяжения, стремящаяся вернуть его обратно. Некоторые из электронов могут удалиться от поверхности на расстояние порядка ~10-10 м, образуя электронное облако. В результате возникает двойной электрический слой подобно электрическому полю конденсатора. На преодоление электрического поля этого слоя и требуется совершение электроном работы выхода. При повышении температуры металла (или другого вещества) кинетическая энергия теплового движения электронов, находящихся вблизи уровня Ферми, увеличивается. Поэтому возрастает вероятность того, что некоторые из электронов могут преодолеть задерживающий потенциал на границе металл - вакуум и выходить из него. Если в вакууме существует электрическое поле, вектор напряженности которого направлен к поверхности металла, то оно будет увеличивать число электронов, покидающих металл, и через вакуум потечет электрический ток. Такой ток называют термоэлектронным, а явление испускания электронов нагретыми металлами - термоэлектронной эмиссией. В зависимости от механизма получения электронами энергии, достаточной для совершения работы выхода, различают несколько видов электронной эмиссии: термоэлектронную, фотоэлектронную (внешний фотоэффект), вторичную электронную эмиссию, ионно-электронную, автоэлектронную. Термоэлектронную эмиссию можно наблюдать в установке с вакуумным диодом, представляющей собой стеклянный баллон, в который впаяны два электрода: катод в виде нити и анод. На рис. 14 приведена вольт - амперная характеристика такого диода, где IS - ток насыщения, когда все испускаемые катодом электроны достигают анода. Плотность термоэлектрического тока насыщения зависит от материала катода, увеличивается с повышением его температуры и описывается формулой Ричардсона - Дешмана:
где В - константа; АВ - работа выхода; k - постоянная Больцмана. Если пользоваться моделью идеального электронного газа, который подчиняется статистике Ферми-Дирака, то константа
одинакова для всех металлов. На участке АБ плотность тока описывается формулой Богуславского - Ленгмюра: где С = Для увеличения срока работы используют катоды с косвенным подогревом и оксидным покрытием веществами, у которых работа выхода электронов меньше. Например, ВаО и SrO и СаО и др. 
12 Не нашли, что искали? Воспользуйтесь поиском по сайту: ©2015 - 2024 stydopedia.ru Все материалы защищены законодательством РФ.
|

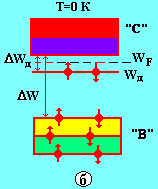 Рис. 3
Рис. 3




 Рис. 6
Рис. 6
 для примесного полупроводника. Участок а-б соответствует низким температурам, вплоть до температуры истощения примеси ТS. Электропроводность на этом участке обеспечивается за счет носителей примеси электронов и дырок, где
для примесного полупроводника. Участок а-б соответствует низким температурам, вплоть до температуры истощения примеси ТS. Электропроводность на этом участке обеспечивается за счет носителей примеси электронов и дырок, где . (6)
. (6) Рис. 7
Рис. 7
 , (7)
, (7) Рис. 8
Рис. 8
 Рис. 9
Рис. 9
 Рис. 10
Рис. 10
 , (8)
, (8) Рис. 11
Рис. 11
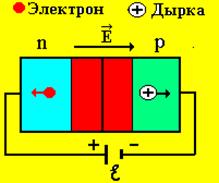 Рис. 12
Рис. 12
 , (9)
, (9) Рис. 13
Рис. 13
 ® 0, а величина плотности обратного тока стремится к предельному значению jS, которая практически достигается при разности потенциалов U » 0,1 В.
® 0, а величина плотности обратного тока стремится к предельному значению jS, которая практически достигается при разности потенциалов U » 0,1 В. Рис. 14
Рис. 14
 (10)
(10)
 (11)
(11) ;
;  - расстояние между анодом и катодом; U - приложенное напряжение; m - масса электрона.
- расстояние между анодом и катодом; U - приложенное напряжение; m - масса электрона.