
|
|
Рекомендуемые травители для выявленияориентации и дислокаций [4,5]
Плотность дислокаций определяют по формуле:
где N – плотность дислокаций, см-2, n – среднее арифметическое из количества дислокаций на пяти участках, S – площадь поля зрения в окуляре микроскопа, см2 Площадь поля зрения зависит от увеличения микроскопа и рассчитывается по объект-микрометру, который представляет собой линейку с ценой деления 0,01 мм. Линейка устанавливается на предметный столик микроскопа, и подсчитывается число делений, попадающих в поле зрения окуляра. Зная цену деления, можно получить диаметр круглого поля и вычислить площадь поля зрения.
Порядок выполнения работы. 1. Методом ямок травления определить кристаллографическую ориентацию и плотность дислокаций предложенных преподавателем образцов. 2. Исследование образцов проводить под микроскопом Ломо МЕТАМ Р-1, окуляр 10, объектив 25. Для оценки цены деления микроскопа использовать объект микрометр с ценой деления 0,01 мм. ГОСТ 7513-75. 3. Внимание! При работе на микроскопе с большим увеличением (малое фокусное расстояние) выполнять следующее правило: предметный столик поднять на предельную высоту, чтобы проконтролировать при взгляде сбоку, и наводку производить только при опускании столика. 3. Результаты занести в таблицу 3. 4. Сформулировать выводы по работе. 5. Подготовить отчет по работе.
Таблица 3 Результаты исследований
Контрольные вопросы. 1. Какие методы определения кристаллографической ориентации полупроводниковых монокристаллов Вы знаете? 2. На чем основан метод селективного химического травления при определении ориентации полупроводниковых монокристаллов? 3. Какие травильные растворы для выявления ориентации и ямок дислокаций на кремнии Вы знаете? Расскажите их состав и принцип использования. 4. Расскажите, как определить плотность дислокаций на кремниевой пластине методом ямок травления. Литература. 1. Сугано Т. Введение в микроэлектронику / Сугано Т. [и др.] – М.: Мир, 1988. – 370 с. 2. Николаев И.М. Оборудование и технология производства полупроводниковых приборов / И.М. Николаев. – М.: Высшая школа, 1977. – 269 с. 3. Кожетов Л.В. Оборудование полупроводникового производства / И.Т. Блинов, Л.В. Кожетов. – М.: Машиностроение, 1986. – 264 с. 4. Физико-химические методы обработки поверхности полу-проводников / Под редакцией Б.Д. Луфт. – М.: Радио и связь, 1982. – 135 с. 5. Бублик В.Т., Дубровина А.Н. Методы исследования структуры полупроводников и металлов / В.Т. Бублик, А.Н. Дубровина. – М.: Металлургия, 1978. – 272 с. 6. Бочкин О.И. Механическая обработка полупроводниковых материалов / О.И. Бочкин [и др.]. – М.: Высшая школа, 1977. – 153 с. 7. Мокеев О.К., Романов А.С. Химическая обработка и фотолитография в производстве полупроводниковых приборов и интегральных микросхем / О.К. Мокеев, А.С. Романов. – М.: Высшая школа, 1985. – 324 с. 8. Амелинкс С. Методы прямого наблюдения дислокаций / С. Амелинкс. – М.: Мир, 1968. – 438 с. 9. Зимин С.П. Методы контроля технологических процессов в электронике: Метод. указания по выполнению лабораторных работ / С.П. Зимин. Яросл. гос. ун-т. – Ярославль: ЯрГУ, 2005. – 64 с.
Лабораторная работа № 3
Цель работы - ознакомиться с теорией четырехзондового метода измерения удельного сопротивления ρ полупроводниковых материалов; провести экспериментальное определение ρ объемных образцов кремния предложенных преподавателем; определить концентрацию примесных атомов в образцах кремния. Теоретическая часть. Физические величины, характеризующие полупроводники, можно разделить на несколько групп. К первой группе относят величины, которые мало зависят от степени чистоты кристаллов, т.е. от присутствия примесей, или от степени дефектности кристаллов. Примерами величин составляющих первую группу, являются ширина запрещенной зоны Eg, эффективные массы электронов и дырок m Ко второй группе относят такие величины, которые существенно зависят от концентрации и вида дефектов, т.е. от содержания примесей, дислокаций и вакансий. К ним относятся концентрации самих дефектов: Nд , Nа , ND и NV, зависимые от них величины: удельное сопротивление Величины, относящиеся к этой группе, в зависимости от содержания дефектов могут изменяться в десятки миллионов раз. Поэтому вариация именно этих величин и обуславливает применения полупроводниковых материалов в самых разнообразных приборах. Эти величины могут одновременно являться технологическими параметрами, характеризующими качество материала, выпускаемого промышленностью. В зависимости от задач, связанных с областью применения материала, выбирают те или иные величины из этой группы в качестве контролируемых. Допустимые пределы их изменения указывают в технических условиях (ТУ) на материал. Методики измерения технологических параметров, которыми руководствуются ОТК заводов, описывают в специальных методических инструкциях, где указывают принципиальные основы методики, требования, предъявляемые к образцам, способы их подготовки и измерениям, принципиальную схему измерения с указанием типов применяемых аппаратов и приборов, метод обработки экспериментальных результатов и гарантируемую погрешность измерений. К третье группе величин, знание которых необходимо для правильной разработки технологии получения полупроводниковых материалов, относят физико-химические величины, например предел растворимости примесей в данном полупроводнике с, коэффициенты распределения к, теплота испарения L, коэффициенты диффузии D и др. В данной лабораторной работе рассмотрим измерение характеристического параметра полупроводников, такого как удельное сопротивление четырехзондовым методом. Зондовые методы основаны на том, что при прохождении электрического тока через кристалл на нем возникает электрическое поле. Если ток
т.е. потенциал этого питающего электрода (в дальнейшем называемый токовым зондом) при
Рис. 1. Точечный зонд на границе раздела двух сред: 1- среда с удельным сопротивлением
Когда используется несколько токовых зондов, потенциал будет определяться набором расстояний r1, r2, …rn, измеряемых от токовых электронов 1,2, …n до точки измерения, которую называют потенциальной. В случае двух токовых зондов потенциал определяется выражением:
U=
где r1и r2 – расстояние от токовых зондов до потенциальной точки. Практически определяют не потенциал, а разность потенциалов ΔU в двух потенциальных точках. Поэтому наибольшее распространение получил четырехзондовый метод, в котором используют два токовых и два потенциальных зонда. В этом случае ΔU является функцией типа ΔU=ΔU(I,
ΔU= Um – Un =
Рис. 2. Векторная диаграмма четырехзондового метода: a, b – токовые зонды; m, n – потенциальные зонды.
Отсюда удельное сопротивление
Величину K называют коэффициентом четырехзондовой головки. В практике нашли применение лишь две конструкции зондовых головок. Это случаи расположения зондов в линию (рис.3. а, б) и по углам прямоугольника (рис.3. д). В общем случае, задавшись соотношением l1/l2 = Величина K при этом равна для линейного расположения зондов
Рис.3. Различные способы расположения зондов на поверхности образцов.
Выражение (4) справедливо лишь для полубесконечных образцов. Это значит, что границы образца как в плоскости расположения зондов, так и по глубине образца удалены от зондов на бесконечность. В реальных случаях за счет конечности образцов удельное сопротивлении
где Fi – поправочный множитель, являющийся функцией межзондового расстояния l, толщины образца d и расстояния от зондов до ближайшей границы образца L. Четырехзондовый метод применяется для измерений, как на пластинах, так и на целых слитках. В последнем случае измерения проводят по торцу слитка и по образующей. Для обычно используемых зондовых головок характерные значение l находятся в интервале 0,7-1,3 мм, а диаметр слитков составляет 20-30 мм. Таким образом при измерении удельного сопротивления по образующей значения l/d всегда больше 0,06, а это значит, что краевой эффект определяется только величиной l/L. Этот вывод тем более справедлив при измерении ρ по торцу слитка, ибо длина слитков всегда больше их диаметра. Для снижения влияния краевого эффекта при измерениях по образующей вдоль слитка делают так называемую измерительную дорожку. Эта операция сводится к шлифованию части цилиндрической поверхности слитка с тем, чтобы зонды располагались на плоской поверхности. Обычно применяют зонды из вольфрама, молибдена, тантала и твердых сплавов типа ВК-6 (WC+6%Co). Зонды необходимо затачивать, так как теория четырехзондового метода предполагает точечность зондов, т.е. диаметр зондов в точке касания с образцом должен быть много меньше всех других размеров, характеризующих систему зонд- образец. Заточку зондов производят электролитически. Принципиальная электрическая схема измерений ρ четырехзондовым методом приведена на рис. 4.
Рис. 4. Схема измерений удельного сопротивления четырехзондовым методом: 1- зонды; 2- источник постоянного тока; 3- токовый прибор; 4- нуль-гальванометр; 5- потенциометр постоянного тока.
В современных схемах в качестве измерительных приборов используют цифровую технику. Измерения проводят компенсационным методом без отбора тока в цепь потенциальных зондов. Этот прием позволяет исключить проявление различных эффектов, возникающих в области контактов металлических зондов с полупроводником. Ошибки измерений четырехзондовым методом могут иметь различную природу. Наибольшая погрешность обусловлена колебанием межзондовых расстояний в процессе измерений. В ряде случаев могут возникать ошибки за счет инжекции носителей заряда из токовых зондов, за счет различных тепловых эффектов, например из-за разного теплоотвода с поверхности кристалла через контакт, из-за нагревательного действия тока, проходящего через образец, и .т.д. Практически общую погрешность измерений удельного сопротивления четырехзондовым методом удается снизить до 5%.
Практическая часть. 
Не нашли, что искали? Воспользуйтесь поиском по сайту: ©2015 - 2024 stydopedia.ru Все материалы защищены законодательством РФ.
|
 (2)
(2) Измерение удельного сопротивления полупроводниковых материалов и пленок четырехзондовым методом.
Измерение удельного сопротивления полупроводниковых материалов и пленок четырехзондовым методом.
 и m
и m  , концентрация собственных носителей заряда ni, параметр решетки а, решеточная теплопроводность
, концентрация собственных носителей заряда ni, параметр решетки а, решеточная теплопроводность  L, температура Дебая
L, температура Дебая  и ряд других. Величины первой группы называют фундаментальными параметрами.
и ряд других. Величины первой группы называют фундаментальными параметрами. , подвижность электронов и дырок un и up, времена жизни, неравновесных носителей заряда τn и τp. Эти величины называют характеристическими параметрами.
, подвижность электронов и дырок un и up, времена жизни, неравновесных носителей заряда τn и τp. Эти величины называют характеристическими параметрами. распространяется в однородной изотропной среде от одного точечного электрода (рис.1.), то напряженность поля
распространяется в однородной изотропной среде от одного точечного электрода (рис.1.), то напряженность поля  и потенциал U в некоторой точке, удаленной от места касания электрода на расстояние r, соответственно будут
и потенциал U в некоторой точке, удаленной от места касания электрода на расстояние r, соответственно будут /(2
/(2  r2); U=
r2); U= 

 , (2)
, (2) . (3)
. (3)
 , где l1 – расстояние между токовым и ближайшим к нему потенциальным зондом; l2 – расстояние между потенциальными зондами, из (3) можно найти K. Наиболее простой случай представляет собой эквидистантную зондовую головку с одинаковыми межзондовыми расстояниями l.
, где l1 – расстояние между токовым и ближайшим к нему потенциальным зондом; l2 – расстояние между потенциальными зондами, из (3) можно найти K. Наиболее простой случай представляет собой эквидистантную зондовую головку с одинаковыми межзондовыми расстояниями l.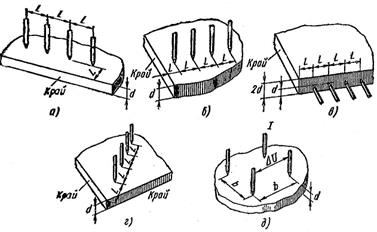
 Fi(l, d, L), (5)
Fi(l, d, L), (5)